2ω法ナノ薄膜熱伝導率計
TCN-2ω

本装置は、2ω法を用いたナノ薄膜の厚さ方向の熱伝導率を測る世界で唯一の市販装置です。他の方式と比べ、試料の製作や測定が簡単に行えます。
用途
- Low-K 絶縁膜の熱抵抗を数値化し半導体デバイスの熱設計に
- 絶縁膜の開発および放熱性の改良
- 熱電薄膜への応用評価
特長
- 基板上に形成された20 ~ 1000nm の薄膜の厚さ方向の熱伝導率測定が可能
- サーモリフレクタンス法を用いた温度振幅検出による測定を実現
- 測定試料の前処理が容易
仕様
| 測定温度 | RT |
|---|---|
| 試料寸法 | 幅10mm×長10 ~ 20mm×厚0.3 ~ 1mm(基板) |
| 測定雰囲気 | 真空中 |
測定原理
金属薄膜に周波数f / Hz で加熱すると加熱量は、2f / Hz で変化します。
金属薄膜( 0 ) ‒ 薄膜 ( 1 ) ‒ 基板 ( s ) の3層系における金属薄膜表面の温度変化 T ( 0 ) は、金属薄膜・薄膜を熱拡散が十分に通過する条件下で、1次元伝熱モデルの解析解を表すと以下の式になります。

(λ:熱伝導率 W m-1 K-1, C:体積比熱容量 J K-1 m-3,q:体積当り熱量 W m-3, d:厚さ m, ω :角周波数 (=2πf ) / s-1)
実数解(in-phase amplitude)に薄膜の情報が含まれていますので、同じ条件下で周波数を変えて測定を行うと、in-phase amplitude は(2ω)-0.5に比例します。
薄膜の熱伝導率λ1 は、以下の式で得られます。
( m:傾き、n:切片)

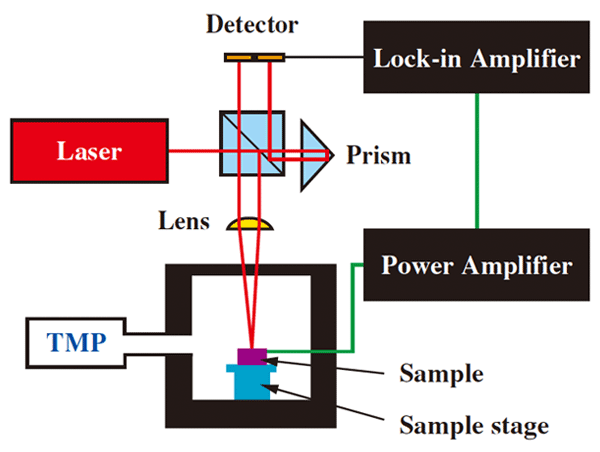
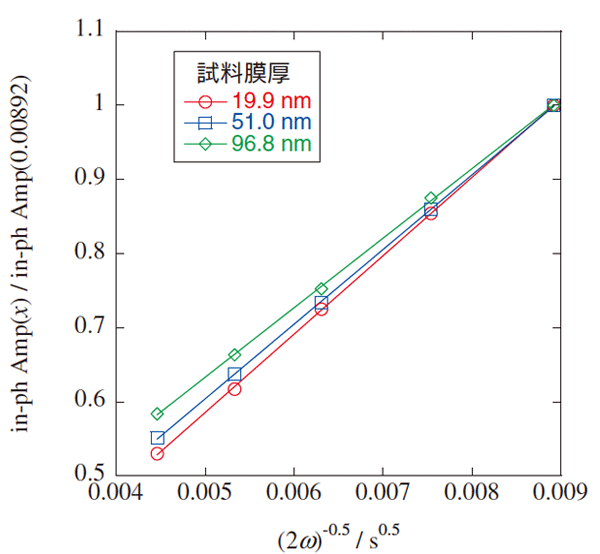
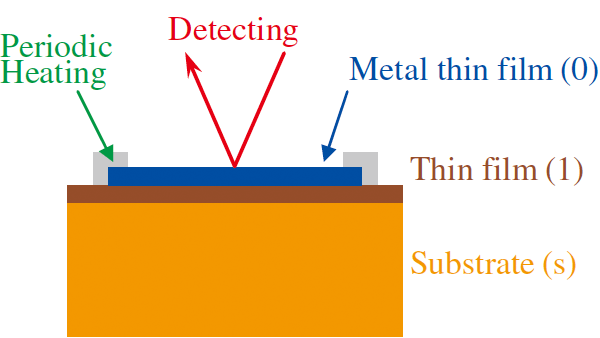
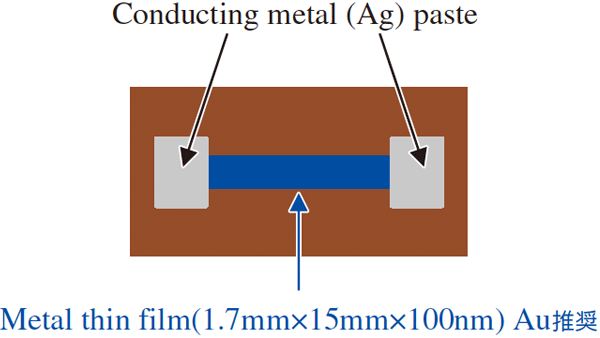
Si基板上SiO2薄膜(20-100nm)の例
| 薄膜の厚さ / nm | 19.9 | 51.0 | 96.8 |
|---|---|---|---|
| 熱伝導率 / Wm-1 K-1 | 0.82 | 1.12 | 1.20 |
特許や規格
熱物性測定方法(特許第5426115号)この製品を利用した受託分析のご案内
2ω法ナノ薄膜熱伝導率計 TCN-2ωお問い合わせ
弊社にお問い合わせを頂くにあたって
お客様にご記入頂いた情報は、お客様へ回答する以外の目的では使用いたしません。
ただし、カタログ請求などの送付をご希望された場合は、発送のために弊社指定の運送業者に住所、氏名等発送にのみ必要な情報を利用させて頂く場合がありますので、ご了承ください。
詳しくはプライバシーポリシーをご確認ください。






